解决方案
SOLUTION

时间: 2026-02-09
浏览量: 443
微机电系统(MEMS)全称 Microelectromechanical System,又称微系统技术(MST)或微型机械,是一个涵盖多种微制造设计、方法与机制的术语,其核心是在微观尺度上实现可运动的机械部件(如图1所示)。

简单来说,MEMS 的核心价值的是将传统庞大的机械系统,转化为微型化、高性能且易于大规模量产的替代方案——这一变革作用,与集成电路、半导体技术对电气电子系统的革新效果极为相似(如图2所示,为MEMS麦克风实例)。

MEMS 的应用范围十分广泛,涵盖传感器、执行器、发生器、能源装置、生化与生物医学系统、振荡器等多个核心领域,具体实例如下:
传感器:MEMS 加速度计、陀螺仪、压力传感器、倾斜传感器及各类 MEMS 谐振传感器;
执行器:MEMS 开关、微型泵、微型杠杆及微型夹具;
发生器与能源装置:MEMS 振动能量收集器、燃料电池及放射性同位素发电机;
生化与生物医学系统:MEMS 生物传感器、芯片实验室、空气微流体传感器及颗粒传感器;
振荡器:用于精准计时与频率控制的 MEMS 振荡器。

当尺度进一步缩小至纳米级别时,MEMS 会演变为纳机电系统(NEMS);若与其他技术集成,还会形成多种复合形态,常见类型包括:
生物微机电系统(bioMEMS):在微制造器件上实现生化与生物医学功能;
微光机电系统(MOEMS/OptoMEMS):集成微镜等光学部件,实现微观尺度下的光线操控与感知;
射频微机电系统(RFMEMS):与半导体微电子紧密集成,具备射频转换与开关能力。
MEMS 器件的技术发展始于20世纪60年代,当时实验室首次演示了 MEMS 压力传感器;80年代进入学术研究快速发展期;90年代正式开启商业化开发与制造进程。如今,MEMS 已深度融入日常生活,智能手机、智能手表、运动手环等设备中均有其身影。
微型化是 MEMS 最显著的发展特征之一:过去飞机驾驶舱中用于确定横滚、俯仰、偏航角度的航空陀螺系统,重量达数千克、长度为几英寸;而如今智能手机中的 MEMS 陀螺仪,重量不足1毫克,尺寸仅相当于一粒沙子。伴随微型化而来的,是制造成本的大幅降低和规模经济效益的显著提升,这与半导体行业“持续微型化、持续降本”的趋势高度一致。

此外,低功耗、高灵敏度也是 MEMS 相较于传统机械器件的核心优势,这是传统机械在物理层面难以实现的:例如,MEMS 谐振应变片功耗仅为微瓦级,灵敏度可达纳应变范围,而传统金属箔应变片功耗为数百毫瓦级,最高精度仅能达到数微应变;传统微量天平的精度局限于数十至数百微克,而 MEMS 微量天平的分辨率可达到皮克甚至飞克级。
制造可扩展性强,大规模量产时单位成本极低;
MEMS 传感器具备极高的灵敏度,性能优于传统同类器件;
MEMS 开关、执行器可实现极高的工作频率,响应速度更快;
器件功耗极低,适配小型化、低功耗电子设备需求;
易于与微电子集成,可实现嵌入式机电一体化系统;
可利用微观尺度下的尺度效应,实现宏观尺度无法达成的设计与动态机制。
研发成本高,新型 MEMS 设计或器件的研发阶段需投入大量资金;
前期设施投入昂贵,制造所需的洁净室、晶圆厂建设成本极高;
小批量生产不具备成本优势,单位制造、组装成本偏高,不适用于小众应用场景(除非成本不受限制);
测试设备价格高昂,用于表征 MEMS 器件质量与性能的专业设备投入较大。
传统 MEMS 器件以硅为微机械加工基材,硅晶圆可通过掺杂实现不同导电水平,同时可添加电极层、压电层等功能材料,赋予器件特定性能。MEMS 的设计与制造是一系列有序步骤与循环过程,具体可概括为以下环节:
设计、建模与仿真:采用解析法、数值法、CAD 及有限元分析(FEA)等方法,完成器件设计与性能预判;
版图设计与晶圆流片:通过版图编辑器绘制器件版图,随后进行晶圆流片;
基底晶圆准备:选用硅、玻璃、石英、不锈钢、塑料等合适材质,制备基底晶圆;
微制造工艺:循环开展增材、图形化、减材工艺,直至获得目标设计形态——
增材工艺:以材料沉积为主,包括化学气相沉积、溅射、蒸发、氧化等;
图形化工艺:包含掩模、光刻、接触式光刻、投影式光刻等步骤;
减材工艺:以材料蚀刻为主,包括湿法化学蚀刻、干法离子/等离子体蚀刻、深反应离子蚀刻(DRIE)等;
芯片切割:采用激光切割、金刚石锯切割、等离子体蚀刻等方式,完成芯片切割;
引线键合:将芯片与接口电路连接,实现信号传输;
封装与密封:采用气密性密封、塑料/陶瓷/金属密封、晶圆级封装等方式,保护器件性能。
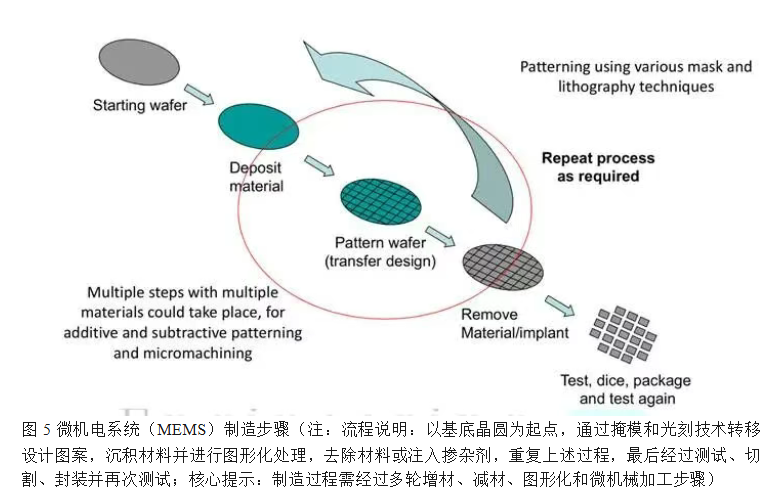
MEMS 器件需通过多种转换机制与外界环境交互,其中最常见的是机械-电信号的相互转换,通过接口电路即可控制 MEMS 器件本身,以及其与机械世界的交互。此外,MEMS 还可通过多种换能器,实现与化学、光、磁、射频(RF)等领域的交互。
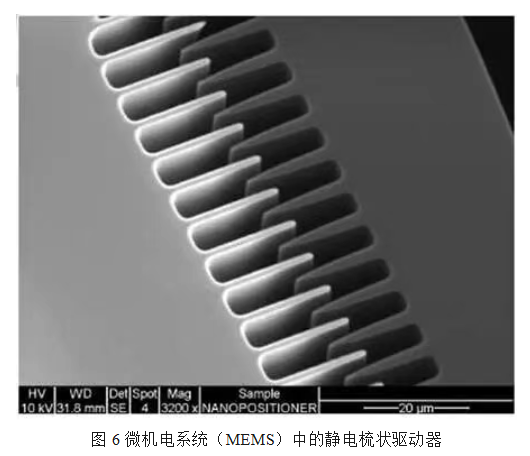
在硅基 MEMS 中,静电式换能器是传统最常用的类型——无需额外特殊材料,微机械加工后的硅通过掺杂即可获得导电性。其工作原理是:在一对电容平行板之间建立电场,维持静电力;当机械运动改变平行板间距时,可测量板间电信号;反之,施加动态电信号可驱动平行板运动。其中,梳齿结构在 MEMS 静电式换能器中应用广泛,核心目的是最大化换能器的电容表面积。
过去十年,随着压电材料微机械加工技术的进步,压电式换能器在 MEMS 设计中的应用日益广泛。适用于 MEMS 的压电材料主要包括氮化铝(AlN)、氧化锌(ZnO)、溶胶-凝胶锆钛酸铅(PZT)、薄体 PZT 及多种铌酸盐复合材料。随着制造技术的不断成熟,未来将有更多功能材料可与硅微机械加工工艺集成。
MEMS 中常用的换能器类型汇总如下:静电式、压电式、铁电式、电磁式、摩擦电式、磁致伸缩式、磁式、射频式(RF)、热式(温度梯度或温度波动)、光学式(光能或光信号)、化学式(微流体)、生物与生物医学式。